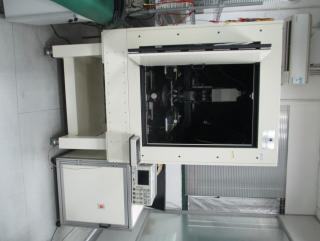
仪器详情
用户评价
功能/应用范围:
Junction Leakage; Contact spiking; Hot Electrons; Latch-Up;
Gate oxide defects/leakage; Poly-silicon Filaments; Substrate damage
Junction Avalanche等
主要技术指标:
当半导体组件有过量的电子-电洞产生时,会因电子-电洞的跃迁而产生红光子,,此可被光子显微镜侦测到。当组件故障是由于氧化层崩溃、静电放电破坏、闩锁效应、撞击游离及饱和的晶体管时,将会产生过量的电子-电洞对,而伴随因电子-电洞跃迁产生的光子,可由光子显微镜精确地定位出此种故障位置。此项技术对集成电路的缺陷是非常灵敏的,然而它也被用来区别是设计或测试条件所衍生的假性缺陷(光激发)。
服务内容:
服务典型成果:
无
用户须知:
对外服务时间:8:30-17:30。参数:Junction Leakage; Contact spiking; Hot Electrons; Latch-Up;
Gate oxide defects/leakage; Poly-silicon Filaments; Substrate damage
Junction Avalanche等。附件:探针座
收费标准:
电询



